IC封装目前逐渐向小型化、多引脚、高集成的方向持续演进,I/O数量也从过去几个引脚增加到现在数万个以上,异构集成、2.5D、3D、SIP技术让芯片封装结构更加集成化、复杂化。
芯片封装技术发展趋势:
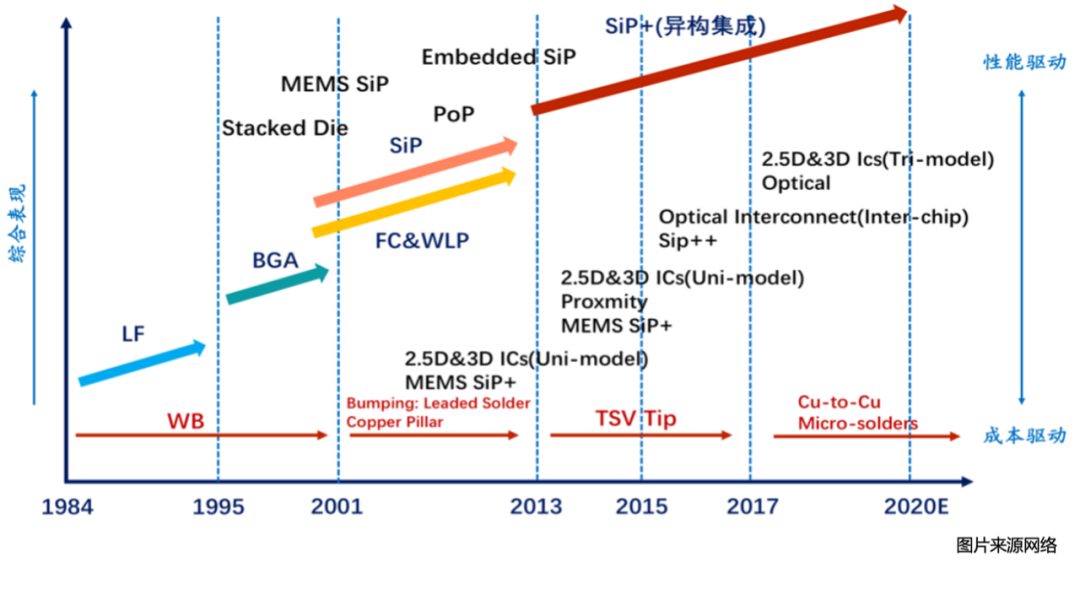
作为后摩尔时代芯片性能提升最有效的途径,先进封装技术快速发展,以FC、ED、stacking、FO为代表的先进封装技术平台已成为中高性能产品封装首选方案。
而FC封装技术凭借成熟、完善的技术工艺平台,良好的电性能、热性能,有竞争力的成本优势,广泛应用于各类中高端半导体器件封装。
目前华天科技针对客户FC类产品的封装需求,从产品的仿真,设计,封装等各方面进行了全方位的布局,能提供基于产品特性的完整的Flip Chip产品解决方案。
1)华天科技仿真能力:
华天科技在2011年开始为客户提供产品仿真服务,积累大量仿真经验和成功案例,目前产品仿真主要关注力学、电性能、模流、热仿真四个方面。
力学仿真
旨在解决产品封装过程中可能出现的结构力学问题,通过材料选择、设计优化、失效现象模拟等手段,预防封装翘曲、芯片分层、裂片等问题,节省封装成本和时间,提高封装可靠性。
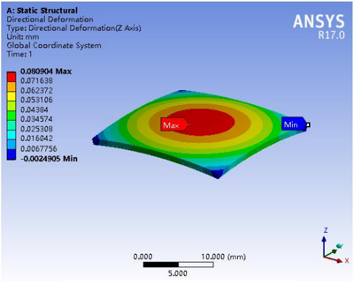
翘曲仿真分析
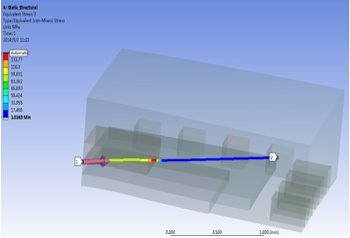
封装界面分层分析

Bump排布分析
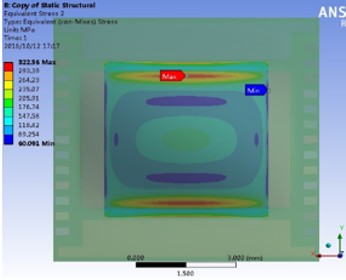
应力仿真分析
电仿真:
主要进行信号完整性和电源完整性分析,规避设计的盲目性,缩短开发周期,提高设计效率。同时可以提取封装体内信号/电源网络的RLC参数,导出IBIS 模型与SPICE 模型。


模流仿真:
应用实体混合网格技术模拟塑封料的填充过程,进行填充分析、冲线分析、导线架偏移分析等,为治具设计、材料设计/选择、制程参数等提供建议。
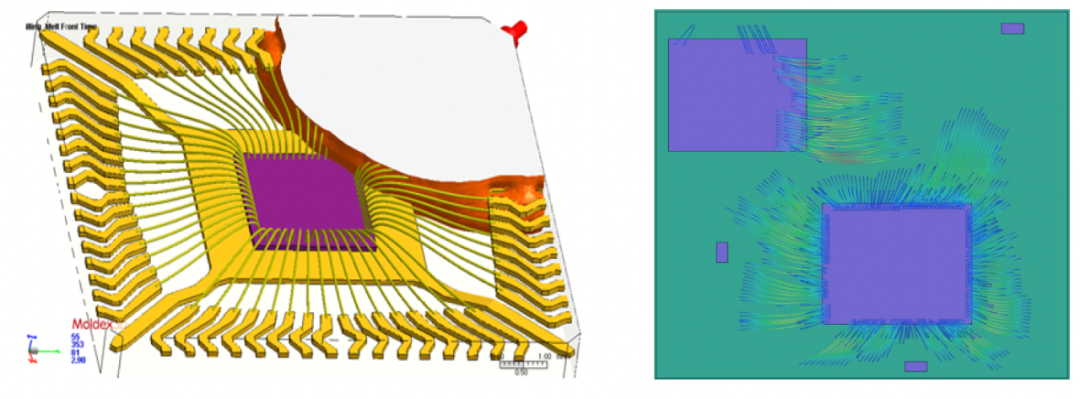
冲线分析
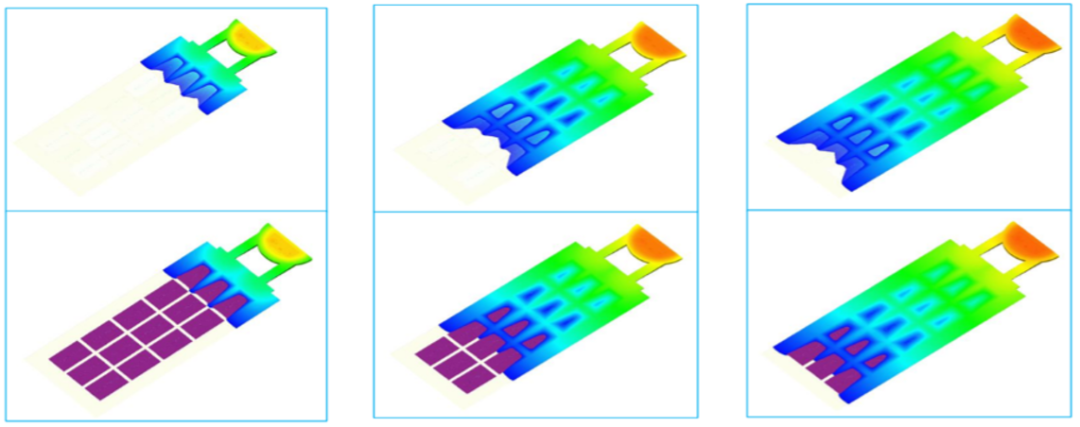
填充分析
热仿真:
可对所有封装形式进行从封装级到系统级的热仿真分析。
提供全面、准确的热性能参数和温度分布、散热瓶颈等信息;
进行不同封装方案的热性能比对,提供散热优化方向。

封装级热仿真
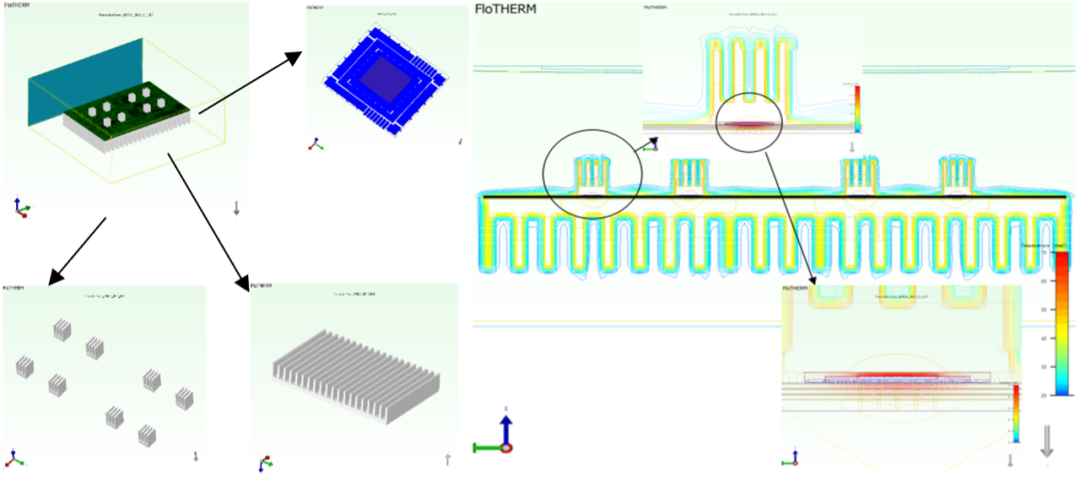
板级热仿真
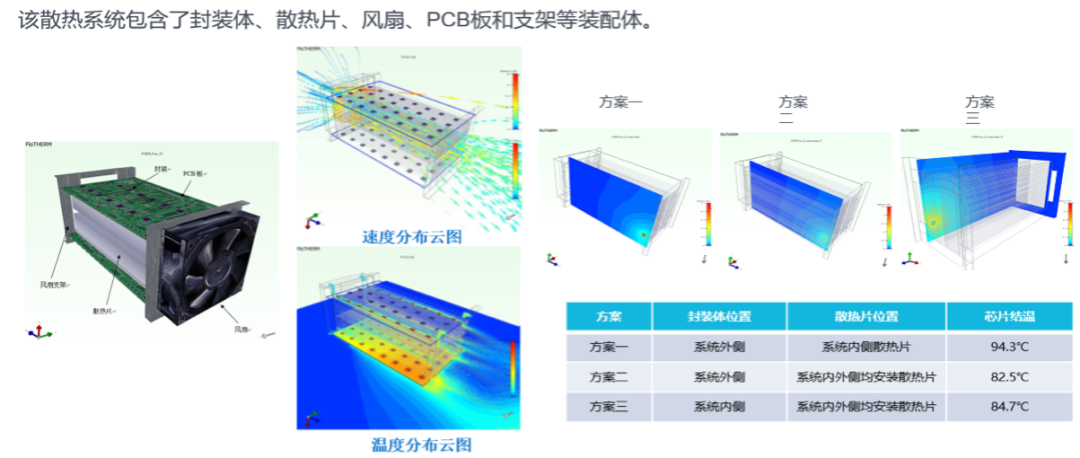
系统级热仿真
2)华天科技FC设计能力:
华天科技拥有专业的封装产品设计团队,可以提供框架级、基板级、系统级、晶圆级产品封装设计,为产品提供有竞争力的封装方案,主要包括:
BD图设计;
基板/框架设计;
封装结构设计及BOM选型;
制定封装设计流程,提升芯片封装良品率及降低芯片封装成本;
为芯片顶层Die Pad排布、RDL及bump摆放提供优化建议;
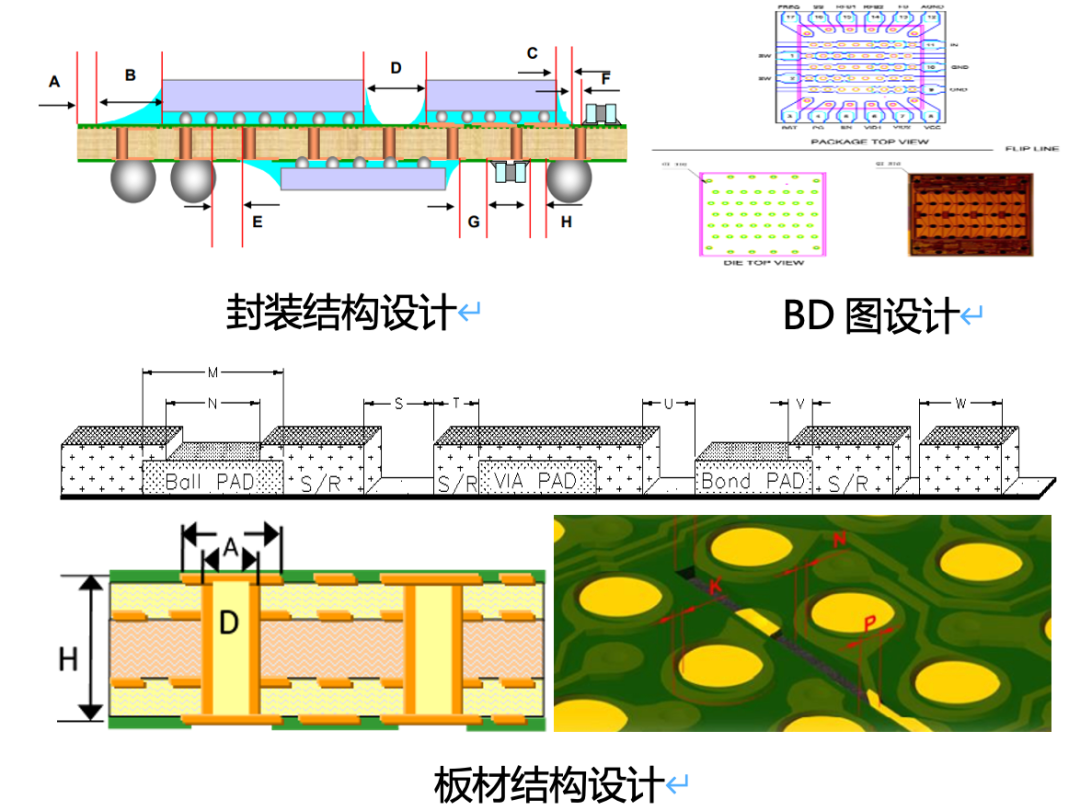
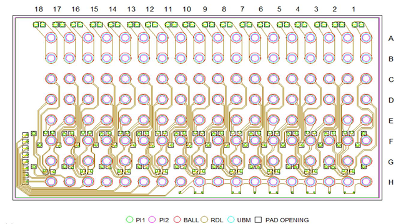
Bumping、RDL结构设计
3)华天科技FC封装技术能力
FCCSP(Flip Chip Chip Scale Package):
FCCSP封装解决方案采用倒装芯片互连技术,封装后,可以让芯片面积与封装面积之比超过1:1.2,具有低功耗,低成本,小体积等特点。华天科技目前的FCCSP技术已具备:SiP、Open Molding、EMI-Shielding、EHS等工艺,而TCB、Double side等工艺也在研发中。
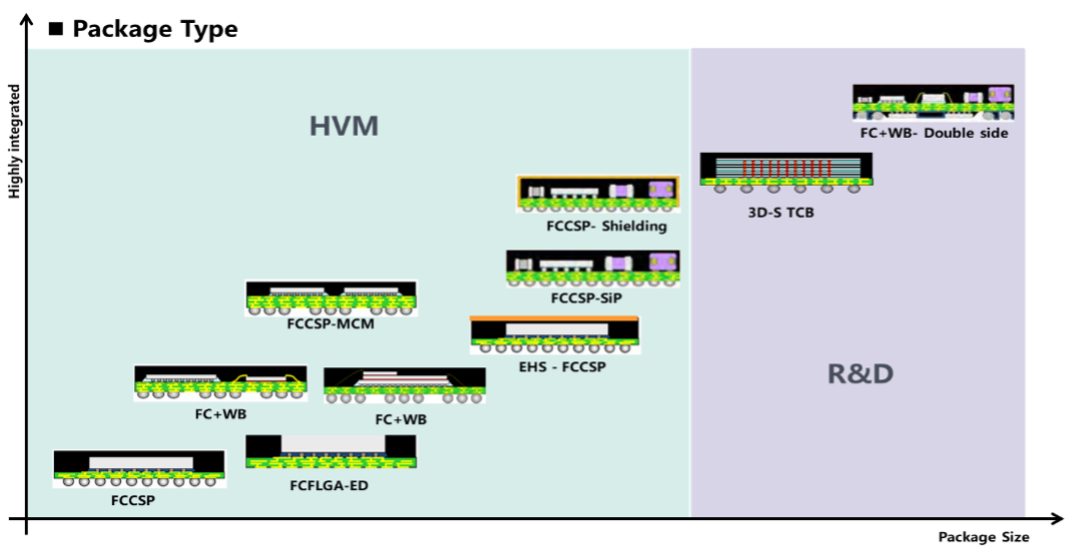
FCBGA(Flip Chip Ball Grid Array):
FCBGA被称为倒装芯片球栅格阵列封装。华天科技的FCBGA封装解决方案种类多样:裸芯片封装、贴散热盖封装(散热盖包括全封和环型两种,散热盖板材料丰富多样)、多芯片封装、重封装、芯片+元器件SiP封装、背贴电容等。
FCBGA封装在芯片背部加装金属散热片,能更进一步强化芯片散热的能力,大幅提高芯片在高速运行时的稳定性。
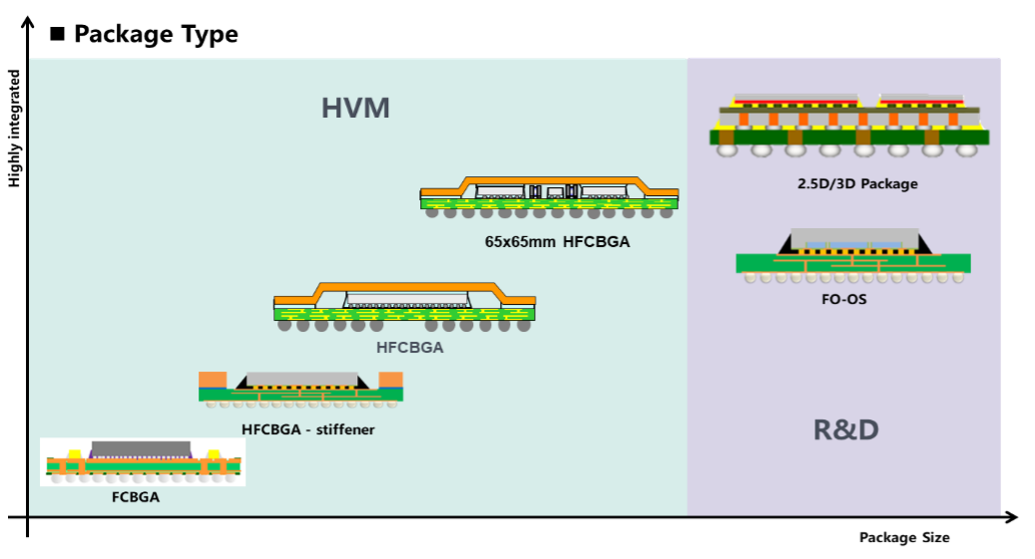
Flip Chip是一种理想的芯片互连技术,通过低成本,高性能及满足高密度封装等方面体现出的优势,在半导体封装领域中占比逐增,目前Flip-Chip已成为OSAT先进封装中的核心业务之一,全球封测行业头部玩家中,Flip Chip占其先进封装业务比超过50%以上。
从2010年开始布局Flip Chip封装技术,2021年Flip Chip封装总出货量超过40亿颗,华天科技致力于成为Flip Chip封装领域的重要方案商,为客户提供丰富多样的Flip Chip封装解决方案,以满足产品不同终端应用的可靠性需求。