来源 :迈为股份2026-03-31
春和景明,万象更新,正是共启“芯”程好时节。3月25日至27日,全球半导体行业盛会SEMICON China在上海新国际博览中心隆重举行。本届展会以“Transform,Tomorrow”为主题,汇聚半导体产业链前沿力量,以变革擘画未来,共拓行业发展新蓝图。
迈为股份携先进封装工艺整体解决方案亮相,系统展示了自主研发的磨划与键合工艺设备,以及主轴、磨轮等配套产品,全面呈现公司集“核心部件、高端装备、关键耗材、先进工艺”于一体的综合能力,诠释其技术创新实力与产品领先优势。展会期间,迈为展台备受瞩目,众多客户与专业观众前来交流洽谈。
磨划设备优势持续巩固
市场竞争力稳步提升
在磨划设备领域,迈为股份的晶圆激光开槽设备成果显著,纳秒/皮秒/飞秒激光开槽设备已累计出货两百余台,产品标准化程度与良品率保持行业标杆水平。
同时,公司自主研发的国内首台干抛式晶圆研抛一体设备取得关键进展,在多家客户端通过工艺验证并获得批量复购订单。


左滑查看更多图片
针对超薄存储器加工推出的全制程解决方案,也已成功导入多家行业领先封测厂商,为存储芯片先进封装提供坚实可靠的技术保障。
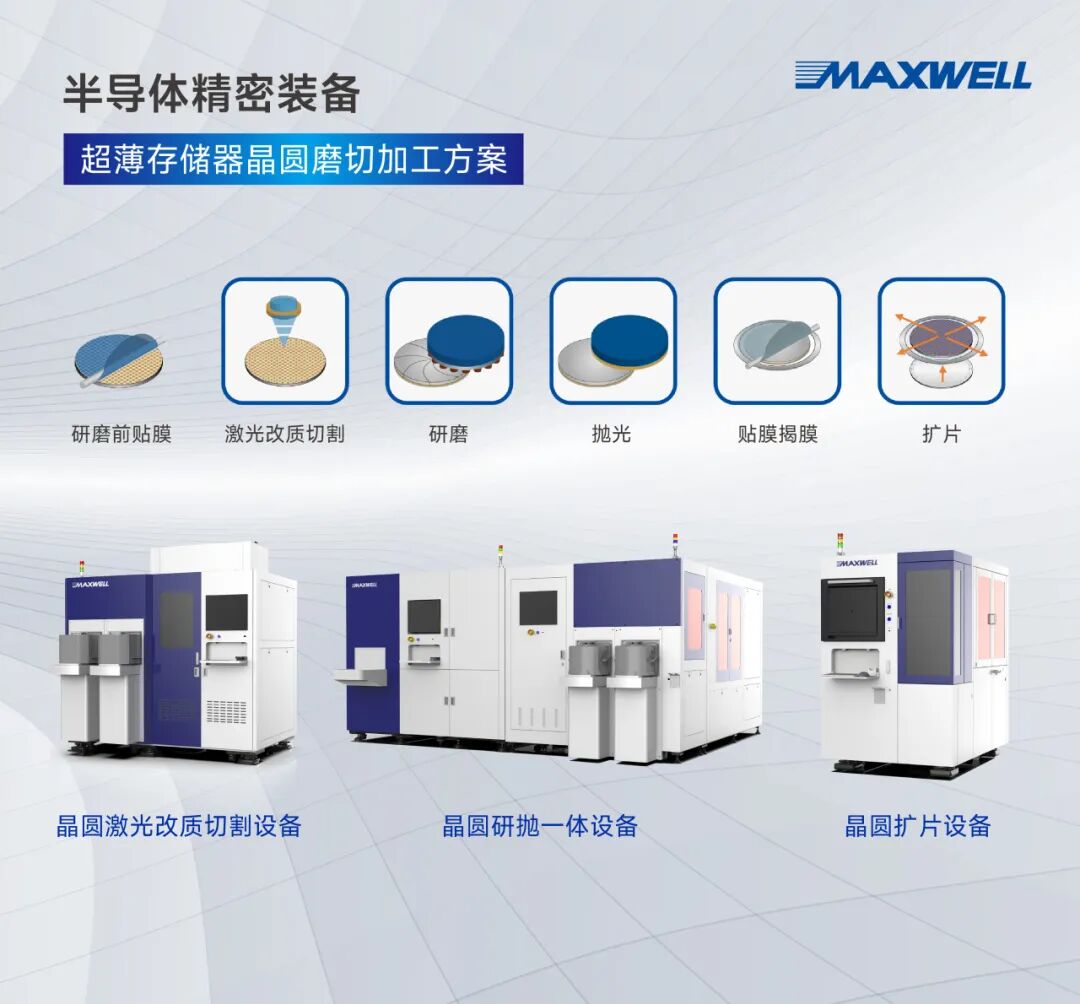
键合设备阵容日趋完善
助力先进封装加速突破
在键合工艺设备领域,公司的晶圆混合键合设备、晶圆临时键合设备、晶圆热压键合设备等已实现批量交付,并在客户端进入稳定量产阶段,设备在精度、稳定性与可靠性等方面的卓越表现,获得客户高度认可。
其中,核心产品晶圆混合键合设备经研发团队持续创新,成功开发全新对准方案,将对准精度从50nm@3σ提升至30nm@3σ,达到国内领先、国际先进的技术水平。该设备已应用于 3D IC、异质异构集成等先进封装工艺,实现超高密度芯片堆叠与互连,助力客户加速突破先进封装技术瓶颈。


左滑查看更多图片
此外,公司基于混合键合工艺首创了3D封装成套工艺设备解决方案,已与多家客户签订整线订单,计划于今年完成交付。该方案涵盖晶圆减薄、激光开槽、等离子体切割、等离子活化和亲水性处理及混合键合等全套设备及工艺,将助力客户构建完整先进封装产线,全面提升量产竞争力。



左滑查看更多图片
本次展会,迈为股份还带来创新开发的碳化硅晶锭剥离成套装备,以更高产出和更短加工时间,驱动碳化硅衬底工艺实现“高效低耗"的智能制造。与此同时,公司推出的碳化硅晶圆激光切割成套装备同样实现关键突破,凭借微米级激光切割与低损耗特性,有效解决了传统切割方案中效率不足、损耗偏高的行业痛点。
未来,迈为股份仍将以自主研发为核心驱动力,聚焦先进封装设备与工艺解决方案的前沿技术突破,持续巩固在技术自主性、供应链安全性、成本竞争力和客户价值创造等方面的综合优势,以创新助力中国半导体产业链高质量发展。