
9月4日,中微公司在第十三届半导体设备与核心部件及材料展(CSEAC 2025)上发布了六款覆盖等离子体刻蚀、原子层沉积(ALD)及外延(EPI)等关键工艺的全新设备,进一步巩固其在高端半导体设备市场的技术领先地位。
此次发布的产品涵盖刻蚀和薄膜沉积两大核心领域,针对先进制程中的关键工艺需求提供创新解决方案,不仅是其向高端设备平台化转型的关键落子,更为国内半导体产业链的自主可控注入了新动能。

中微公司董事长尹志尧作主旨演讲
在本次展会上,中微公司董事长尹志尧针对当前行业现状,提出行业内存在多达15种“内卷”表现,如“现场解剖复制设备”、“设备商与零部件商不公平条款”、“利用媒体诋毁竞争者”等,直指行业恶性竞争痛点。他也指出,“产业链过分垂直整合”也是一种“不公平竞争”。
新品矩阵:精准覆盖关键工艺需求
此次发布的新品包括两款刻蚀设备与四款薄膜沉积设备,精准锚定半导体制造中的高难度环节。在刻蚀领域,新一代极高深宽比等离子体刻蚀设备Primo UD-RIE尤为亮眼――基于成熟机型Primo HD-RIE升级而来,配备六个单反应台反应腔,通过更低频率、更大功率的射频偏压电源,可提供更高离子轰击能量,既能满足先进芯片中“极高深宽比结构”的刻蚀要求,又兼顾了精度与生产效率。
据介绍,Primo UD-RIE?引入了多项创新技术,自主研发的动态边缘阻抗调节系统通过调节晶圆边缘等离子体壳层调节边缘深孔刻蚀的垂直性,大大提高了晶圆边缘的合格率。其上电极多区温控系统,优化了高射频功率下的散热管理,有效提升了设备的稳定性和可靠性。同时,Primo UD-RIE?还采用了全新的温度可切换多区控温静电吸盘和主动控温边缘组件,不仅提高了抗电弧放电能力,还显著提升了晶圆边缘的良率,为生产先进存储芯片提供了有力保障。

另一款Primo Menova 12寸ICP单腔刻蚀设备则聚焦金属刻蚀(如Al线、Al块刻蚀),适用于功率半导体、存储器件及先进逻辑芯片制造,成为晶圆厂金属化工艺的核心支撑。这款设备在刻蚀均一性控制方面表现卓越,可实现高速率、高选择比及低底层介质损伤等优异性能。同时,其高效腔体清洁工艺能有效减少腔室污染、延长持续运行时间;集成的高温水蒸气除胶腔室(VoDM strip chamber)可高效清除金属刻蚀后晶圆表面残留的光刻胶及副产物。此外,主刻蚀腔体与除胶腔体可根据客户工艺需求灵活组合,最大限度满足高生产效率要求,确保高负荷生产中的稳定性与良率。
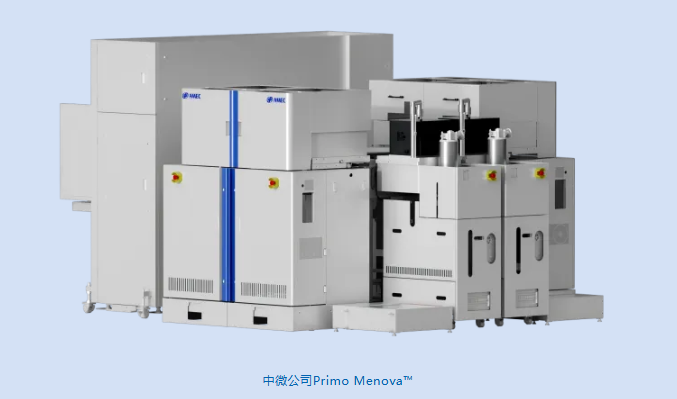
中微公司还推出12英寸原子层沉积产品 Preforma Uniflash?金属栅系列,成为薄膜沉积领域的一大亮点。该系列涵盖Preforma Uniflash? TiN、Preforma Uniflash? TiAI及Preforma Uniflash? TaN三大产品,能够满足先进逻辑与先进存储器件在金属栅方面的应用需求。
此外,中微公司全球首款双腔减压外延设备PRIMIO Epita RP更是行业焦点――其反应腔体积为全球最小,却可灵活配置多达6个腔室,在降低生产成本与化学品消耗的同时,通过多层独立气体分区、径向温场调节等技术,实现了流场与温场的极致均匀性,可适配从成熟制程到先进节点的逻辑、存储及功率器件外延工艺需求。
构建壁垒:持续加大研发投入
中微公司始终坚持突破创新,强调“技术的创新、产品的差异化和知识产权保护”。尹志尧介绍,中微公司持续加大研发投入,铸就技术高壁垒。2025年上半年公司研发投入约14.92亿元,同比增加5.21亿元,同比增长约53.70%;2025年上半年研发投入占公司营业收入比例约为30.07%,远高于科创板上市公司的平均研发投入水平。
目前,中微公司在研项目涵盖六类设备、超二十款新设备的开发,包括新一代的CCP高能等离子体刻蚀设备、新一代的ICP低能等离子体刻蚀设备,晶圆边缘刻蚀设备,低压热化学沉积LPCVD及原子水平沉积ALD等薄膜设备、硅和锗硅外延EPI设备,新一代等离子体源的PECVD设备和电子束量检测等设备。尹志尧表示,“过去通常需要三到五年开发一款新设备,现在只需两年或更短时间就能开发出有竞争力的新设备,并顺利进入市场。”
据中微公司介绍,这六款新品是其“加速向高端设备平台化公司转型”的重要抓手。数据显示,公司等离子体刻蚀设备已覆盖国际一线客户从65nm到5nm的产线。截至2025年6月底,公司累计已有超6800台等离子体刻蚀和化学薄膜设备的反应台,在国内外155条生产线实现量产和大规模重复性销售,深度融入全球半导体产业链。
此次新品发布,进一步补全了薄膜沉积(尤其是ALD与外延)这一关键环节,形成了“刻蚀+沉积”的全工艺覆盖能力,为下游晶圆厂提供了更完整的本土设备解决方案。
此外,中微公司也在泛半导体微观制造领域不断拓展产品布局,包括制造氮化镓基发光二极管,Mini-LED和Micro-LED的MOCVD设备,用于红黄光LED的MOCVD设备,制造碳化硅和氮化镓功率器件的MOCVD设备,制造MEMS的深硅刻蚀设备,先进封装Chiplet所需的TSV刻蚀设备和PVD设备,新型显示技术领域所需的核心薄膜及等离子体刻蚀设备等。
行业内卷:15种典型内卷形式
尹志尧同时指出,当前中国的芯片设备行业存在多达“15种内卷形式”。这一论断在行业内引起了广泛关注。具体内容如下:
1.技术窃取与复制:非法获取核心机密的“拿来主义”
部分企业通过窃取(甚至雇佣第三方)国内或国外领先竞争者的设计图纸、工艺配方、软件编码,直接复制其设备;或借助客户、其他渠道对竞争者设备进行现场解剖、反向工程,绘制图纸复制零部件(包括消耗件),甚至尺寸都完全一致。
2.专利无视与违规:漠视知识产权的“野蛮生长”
不少企业不研究、不了解竞争对手、客户及供应商的专利,直接按其专利设计设备、采用有专利保护的工艺方案开发工艺,明知故犯违反对方专利,将专利保护视为“无物”。
3.客户“投喂”核心技术:制造端的“自毁长城”
部分芯片制造商为培养多个竞争者,将某一设备商成功设备的详细设计、运转的“know-how”(最佳实践)、成功与失败经验直接传授给另一竞争者,帮助后者走捷径追赶,破坏了市场的公平竞争环境。
4.高薪挖角搅乱人才市场:人才的“无序争夺”
企业从竞争者或客户处高薪挖角关键员工,给予高于市场30%-50%甚至加倍的工资、不适当提级,将人才争夺演变为“价格战”,严重扰乱了半导体设备行业的人力资源市场秩序。
5.员工带密跳槽:商业机密的“被动泄露”
员工离职时,通过下载公司设计图纸、工艺配方、软件编码等技术资料,带到新公司直接用于设备开发,或在工作中透露原公司的商业机密、技术细节,导致企业核心资产流失。
6.重复投资与盲目扩张:资本的“无效消耗”
投资商在原投资公司上市后,用赚取的资金再次投资同类设备公司,与原公司竞争;或员工离职创建同类公司,采用完全相同的技术开发设备,导致行业内产能过剩、资源分散,低成功率成为常态。
7.设备商投资零部件的“霸王条款”:供应链的“强制垄断”
设备商投资零部件及材料厂商时,提出不合理要求,如不允许被投资厂商为竞争者提供零部件(除非联合开发的知识产权且有合理限制);或要求零部件商以明显高于提供给原公司的价格向竞争者供货,造成零部件领域的不公平竞争。
8.舆论诋毁与媒体操控:形象的“恶意攻击”
企业在客户端、公开场合甚至通过关系密切的媒体、记者,散布不利于竞争者的言论、发表诋毁文章,借助舆论优势削弱对手的市场竞争力,而非通过提升自身产品实力获胜。
9.垂直整合的垄断尝试:产业链的“封闭循环”
历史上部分大型芯片制造公司既搞芯片制造、又搞设备、还搞关键零部件,试图通过产业链过分垂直整合达到垄断目的。这种模式下,制造公司可能通过设备进场将自身“know-how”透露给设备商,同时设备商参与制造也可能泄露客户的技术机密,其他制造公司因忌惮而忌讳购买此类公司的设备。
10.客户传授经验的其他形式:间接的“技术转移”
除直接提供设计细节外,部分客户还会将设备商的成功经验、工艺优化技巧等传授给竞争者,帮助其缩短研发周期、降低试错成本,间接削弱了领先企业的技术优势。
11.联合开发的限制滥用:知识产权的“过度保护”
对于联合开发的零部件,设备商要求零部件商不得向任何竞争者提供,即使这些零部件是基于双方共同投入开发的,也未给予竞争者公平的获取机会,阻碍了行业内的技术交流与资源共享。
12.低价竞争的无序化:价格的“恶性循环”
部分企业为抢占市场份额,不惜低于成本价销售设备,忽视产品质量与技术创新,将市场竞争演变为“价格战”,导致行业内企业利润普遍下滑,无法投入足够资金用于研发。
13.地方政绩驱动的盲目投资:政策的“扭曲执行”
为追求地方政绩,部分地区盲目支持新建半导体设备公司,忽视市场需求与企业实际能力,导致区域内企业同质化竞争严重,资源浪费现象突出。
14.关键技术与经验的“共享”失衡:竞争壁垒的“人为降低”
部分企业为获得短期利益,将自身掌握的关键技术、工艺经验无偿或低价分享给其他企业,破坏了行业的技术壁垒,导致整个产业的技术进步放缓。
15.国际竞争中的“价格倾销”:海外市场的“无序扩张”
部分企业在国际市场上通过低价倾销设备,抢占市场份额,不仅扰乱了全球半导体设备市场的价格体系,还可能引发国外企业的反倾销调查,损害中国设备企业的国际形象。
其中,尹志尧着重强调,产业链过分垂直整合是一种不公平竞争。他认为,当产业链中的某个巨头(通常指芯片制造厂或大型集团)利用其市场地位和资本优势,过度向上游设备和材料领域延伸,形成一个封闭的生态系统时,就可能对独立的、专业的设备供应商构成不公平竞争。这种整合可能导致独立的设备商被排挤出供应链,市场机会减少,创新动力受挫。
